一、【科学背景】
二维(2D)半导体由于其超薄结构和优异的电学性能,被视为下一代高性能电子器件和高度集成电路的理想材料。过去十年间,研究者已成功展示了多种基于2D半导体的原型器件与小规模集成电路,显示出其在微纳电子领域的巨大潜力。然而,要实现2D半导体在实际工业中的广泛应用,关键在于能够在晶圆尺度上制备具有高结晶质量和可控层数的2D材料。以二硫化钼(MoS2)为代表的过渡金属硫族化合物(TMDs),由于可以通过外延生长获得高质量薄膜,成为研究热点。但受限于晶格匹配与热力学条件,目前外延法仅适用于特定基底,且厚度一般不超过三层,同时对层间取向有严格要求。为了突破这一限制,研究界提出了“转移-堆叠”策略,通过分层转移与堆叠实现定制化的2D同质或异质结构。然而,该方法在处理与基底结合力强的外延薄膜时存在困难,且常用的聚合物中间层会引入污染或损伤,影响材料品质。因此,如何在保持2D材料高质量和界面洁净度的同时,实现大面积层数与取向可控的结构构筑,成为当前2D半导体领域亟需解决的关键科学与工程问题。这一问题的解决将为高性能晶圆级2D电子器件的发展奠定基础。
二、【创新成果】
近日,松山湖材料实验室张广宇研究员在Nature Electronics上发表了题为“Direct bonding and debonding of two-dimensional semiconductors”的论文,该研究提出了一种无需中间层的直接晶圆键合-解键合方法,实现了在高黏附基底上外延生长的2D半导体单层的高质量层间组装,制备出界面超洁净、层数与扭角可精确控制的同质与异质结构晶圆。该方法实现了高质量2D半导体晶圆级层工程化的可控构筑,为下一代高性能电子器件奠定了新技术基础。

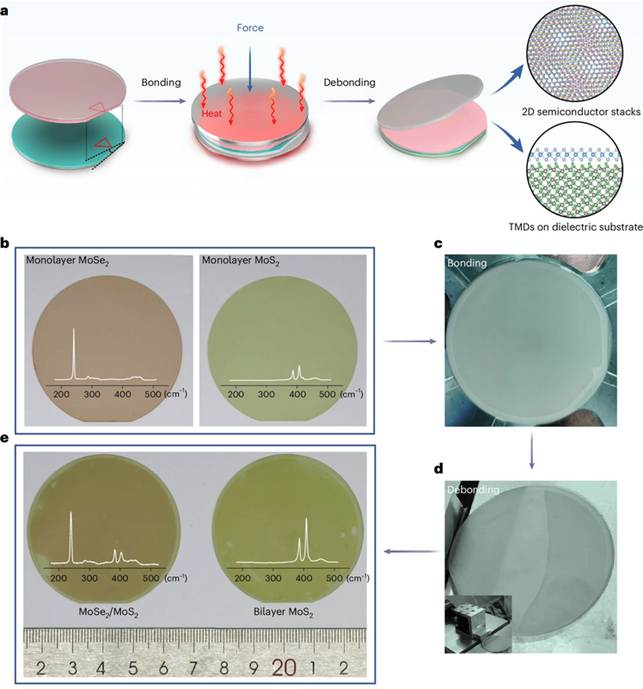
图1. 通过键合–解键合实现2D材料的晶圆级转移 © 2025 Springer Nature

图2 通过键合–解键合获得的2D材料堆叠结构具有的洁净表面与界面表征 © 2025 Springer Nature

图3 光学性质与扭转角的晶圆级均一性 © 2025 Springer Nature

图4 将MoS2从蓝宝石转移至HfO2表征 © 2025 Springer Nature
三、【科学启迪】
该成果为实现高质量2D半导体晶圆级集成提供了新的技术路径,有助于突破长期以来限制2D材料在工业化应用中的关键瓶颈。其无需中间层的直接键合–解键合方法,不仅实现了层数与扭角的精准控制,还保持了材料的本征性能与晶圆级均一性。这一方法为构筑高洁净度的同质与异质结构提供了通用平台,将极大推动“扭转电子学”等基础研究的发展,并加速2D半导体在高性能芯片、柔性电子和光电器件中的应用转化。该成果的科学启示在于揭示了2D材料可通过工程化层控制实现从实验室向产业化的跨越。
原文详情:https://www.nature.com/articles/s41928-025-01474-3





